Cost effective, Desktop Plasma ALD
Desktop Plasma ALD System
The AT650/850P is a compact desktop plasma ALD system that delivers high-quality films with deep penetration. The system can process smaller wafers up to 8 inches for the AT 850P. It features a hollow cathode plasma source and a 60 MHz RF generator, providing high electron density and low plasma damage, suitable for applications requiring precise film characteristics.
FEATURES

- Small Footprint (38.1 cm; 15″ across) Desktop Plasma ALD
- High efficiency, remote 300 watt hollow cathode source and 60 MHz RF generator
-
Features: low oxygen contamination, high electron density, low plasma damage
-
- Integrated matching network
- Accommodates samples of 6″ diameter with optional customizable chucks.
- Warm walled aluminum chamber with heated sample holder from 40 – 450 °C (580 °C available)
- 4 organometallic precursors can be heated to 175 °C.
- Up to 4 oxidant/reductant sources each with ultrafast MFCs (2 standard)
- High temperature compatible fast pulsing ALD valves with an ultrafast MFC and
integrated inert gas purge - High exposure available with static processing mode
SPECIFICATION
- Substrate temperatures from 40 to 450 °C ± 1 °C (580 °C optional) ; Precursor temperatures from RT to 175 °C ± 2 °C (w/ heating jacket)
- Small footprint (15″ by 15″), bench top installation and fully cleanroom compatible
- Simple system maintenance and low utilities cost.
- Streamlined chamber design and small chamber volume
- Fast cycling capability and high exposure, deep penetration processing available
- Full HW and SW interlocks for safe operation even in multi-user environment.
OPTIONS
- Customized chuck/platen
- High temperature chuck up to 580 °C
- QCM (Quartz Crystal Microbalance)
- Additional Counter reactant lines (MFC controlled) – up to 2 additional
- Optional bubbler available with pressure boost technology
- Load lock (or glove box integration)
- External control – PC/software link (allows programming and running, remotely)
- Higher than standard pressure regime
-
Customized systems
FACILITIES
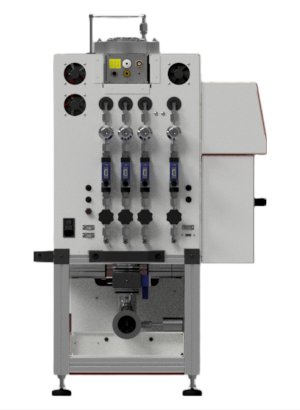
For detailed instructions see our presentation and video instructions: “AT650P Installation and Start-up“
- N2 purge gas should be >99.9995% with a shutoff valve (regulated to 10 – 30 psi, metal sealed).
- Input line is 1/4 female VCR compression fitting
- Attach > 99.9995% nitrogen (UHP) purge gas via 1/4″ metal line to the 1/4″ compression fitting on back
- Attach 90-110 psi CDA (clean dry air) via 1/4″ polyethylene tubing or metal line to the other 1/4″ compression fitting marked CDA (Clean Dry Air)
- Min 19.5cfm wet pump (**PTFE vacuum fluid (like Fomblin) required) (Dry pump is optional)
- NW40 (1.5″) connection and also exhaust line (with > 5cfm draw)
- Greater than 1 meter should use NW50 exhaust line
- Precursor’s attach via female VCR elbows (always use new gaskets).
- Elbow: 1/4″ gasket first (with gloves on)
- For precursor attachment please refer to “AT650P Tool and Software Operation”
SOFTWARE
For detailed instructions see our presentation and video instructions: “AT650P Installation and Start-up“
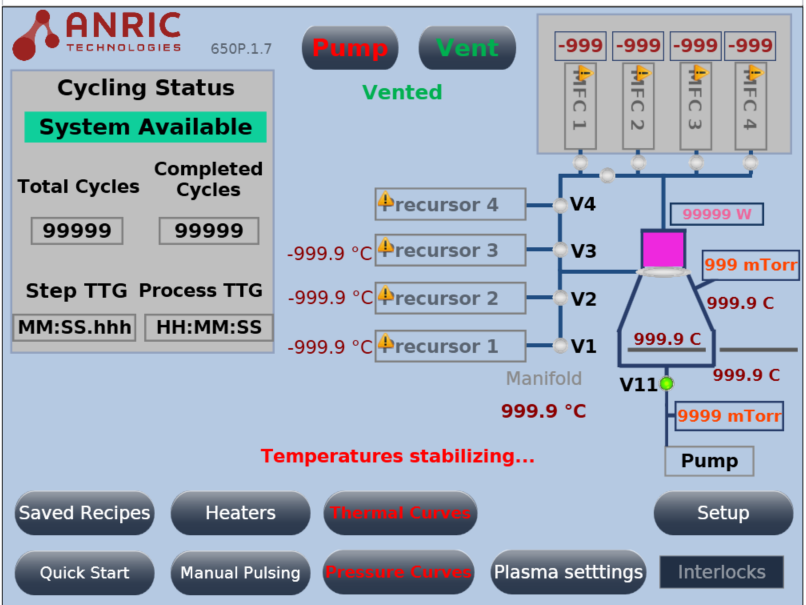
- Human Machine Interface (HMI) PLC system with a 10” touch screen panel
- Advanced controls suitable for the deposition of standard ALD cycles as well as e.g. Nanolaminates, Doped Thin Films and Ternary Thin Films
- Recipe database for high quality, tested processes
- Custom recipe input screen
- Real time display of process status
- Individually programmable heated source temperatures
- Built-in pulsing sequences for ternary compounds and nano-laminates
- Quick running with simple questions to get user going
- Input subcycles and overall cycles



